2011年のブログ一覧①
2011年
11月
01日
火
パソコンはなぜ壊れるのか(前編)
工房やまだでは、最近とある修理業者さんからのご依頼でパソコンの修理をしています。

その業者さんが修理のご依頼をお客様から受けて診断します。
診断の結果BGA部分の不良であると分かった時だけ工房やまだに基板が届きます。
夏ごろから何台もパソコンの基板が届き、修理をしてきましたが、
すべて、GPUの不良です。
なぜ、GPUの不良ばかりなのでしょうか?
GPUの不良が多い理由
理由は大きく2つ考えられます。
まず、1つ目は熱です。
①、熱
GPUはBGAタイプのLSIです。
BGAとはBall Grid Arrayの略で
LSI本体の底面に半田のボールがあり(バンプといいます)
バンプで基板と接続しています。

GPUは電力を集中的に使用して多くの処理を行います。
なので当然熱を持ちます。
PCの能力はCPUやGPUの処理能力と冷却の性能が重要です。
して、発熱するとどうなるか。

上の図はとても大げさですが、
GPUが働くことで加熱し、それが冷める事で、基板が局所的に熱にされされ、基板は次第に反っていきます。
基板が反ると面で基板と実装されているBGAの4辺はどこかに無理がかかります。
②、Pbフリー半田
皆様は半田が大きく分けて2種類あるのをご存知でしょうか?
基板の製造に関わっている人であれば当たり前の事ですが、そうでない方は知らないかもしれません。
半田は、有鉛半田と無鉛半田の2種類あります。
有鉛半田は共晶半田とも言い世界中で古来から使われているものです。
調べてみると紀元前から使われているそう。
http://ja.wikipedia.org/wiki/はんだ
簡単に言うとスズと鉛の合金です。
比較的低い温度(183℃)で融解し、ぬれ性が高いです。
(*ぬれ性:接合部での半田の広がりの良さ、なじみやすさ)
近年、含まれている鉛が環境に悪影響があるとして代替品に置き換わってきています。
EUでは人命に関わる重要な設備の基板以外では共晶半田を使うことはできません。また各国もそれに習っている状態です。
無鉛半田はその為の代替品となるものです。
鉛が入っていないため無鉛ですね。Pbフリーともよく言います。
多くの種類があるのですが、融点は220℃前後と共晶にくらべ高く、ぬれ性も悪い場合が多いです。
また、共晶半田に比べ硬くてもろいのが特徴です。
融点の違いはとても大きいです。より加熱しなくてはなりませんし、使用する部品の耐熱性を上げる必要があります。
しかし、それと同じくらい問題なのは「ぬれ性が悪い」「もろい」という点です。
つまりどういうことか。
Pbフリーで実装された製品は共晶で実装された製品に比べて、信頼性が低いということです。
結果どうなったか
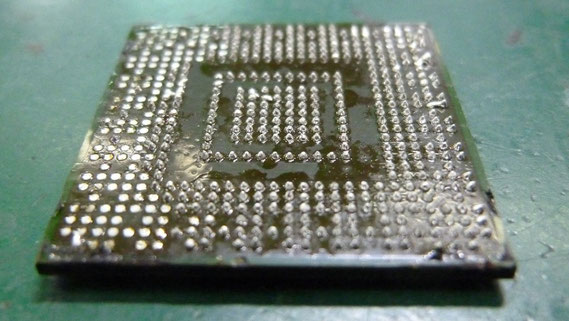
上の写真は不良だと診断されたGPUを基板から取り外したばかりの状態です。
BGAタイプのLSIの裏側、半田バンプが並んでいる部分にあたります。
おかしい部分、わかりますか?
2011年
7月
11日
月
BGAの半田条件を変える(Pbフリー→共晶)
工房やまだではBGA部品のボールの乗せ代え(リボール)を行っています。
BGAの実装不良で交換したい!けど交換する代わりのBGAがない!
そんな時に一度はずしたBGAのボールを再生して実装し直すというサービスです。
しかしこのリボール、もう少し用途があるんです。
色々な問題からPbフリーの実装条件ではなく
共晶の条件で実装しなければいけない場合があります。
そのような場合には共晶仕様の部材を集めて共晶の条件で実装するという事になりますが、
現在出回っている部材は多くがPbフリーに置き換わってきてしまっており
共晶仕様の部品が手に入らないという事も十分にありえます。
もしPbフリー仕様のBGAが手に入らなければリボールしてしまうのも一つの手です。
BGAからPbフリーの半田ボールを取り除いて共晶の半田ボールを載せ代えることで
共晶の温度条件のリフローで実装することが出来るようになります。
工房やまだでも時々BGAの半田ボールを
Pbフリーから共晶へリボールする依頼を頂いています。
関連記事
2011年
7月
01日
金
改造、リワーク専門の実装屋から見る「BGA」
BGAとは、
電子機器の数多ある部品で、ICやLSIと呼ばれる集積回路の内、
端子が部品の底面に付いたボールであるもの事です。
Ball Grid Arrayの略です。
BGAとは

LSIの表面実装タイプの物で一般的なのは上の写真左からSOP、QFP、BGAの3つです。
この内、SOPとQFNは端子が部品の側面に出ていて、BGAは裏側に出ています。
(写真のBGAは逆さまにおいています。)
この形状が実装の難しさに影響しています。
BGAとSOP,QFPの違い
BGAの実装がSOPやQFPと異なる点をあげて行きます。
① SOP、QFPは実装の状況が目で見えるが、BGAは見えない。
② SOPやQFPは端子が四角い部品の辺にあり、基板と「線」で実装される。
BGAは端子が底面にあり、基板と「面」で実装される。
③ SOPはリフロー、半田ごて、それぞれの方法で実装できるが、
BGAはリフローによる実装しか出来ない。
これらの違いがどういう問題を引き起こすか。
①の理由からBGAの付いた基板の実装検査にはX線等を使わないといけなくなります。
②の理由から、実装する基板に「反り」があると
BGAの端の端子が接続しないなどの不具合が出てきます。
そして、③の理由。不具合が見つかった後に修正(リワーク)が難しいということです。

BGAの取り外しには半田ごてを使うことが出来ません。
また基板に既に様々な部品が実装されている為に局所的にBGA部分のみを加熱して半田を溶かす必要があります。
リワーク機
そのために用いる装置がリワーク機(リワークシステム)です。
このリワーク機はまさにリワーク専用機なので
それなりにBGAの実装をしている所では持っているところも多いですが、
BGAのリワークという作業自体が毎日発生するものでは無い為、
使いこなすのが難しいのではないでしょうか。
また、リワークする基板が何十枚もあって更にサンプルもあるなんて場合には
条件出しをしながら取り外し、実装が出来ますが
中々そのような事もないでしょう。

一つしかない基板のBGAを一発勝負で直す!
ここがやはり難しい所で、こういった依頼は多いです。
BGA実装ならBGAの専門家 工房やまだまで!
TEL:0238-22-0771
FAX:0238-26-2361
Email:info@koboyamada.jp
2011年
4月
22日
金
HP更新-ページ内容を更新しました。
試作基板実装のページに チップ部品の取り付け作業の動画を、
基板改造、修理のページにチップ部品の取り外し作業の動画をそれぞれ載せました。
工房やまだでは一つ一つの作業になるべく特別な道具を使わずちょっとした工夫で出来ないかを考えながら日々改善をしております。
2011/4/22
2011年
4月
11日
月
HP更新-Q&Aのページを作成しました。
駆け込み寺(Q&A)のページを作成致しました。今までのお客様より頂いたお声を事例ごとに掲載いたしました。もし思い当たることがあれば工房やまだまでお問い合わせ下さい。精一杯ご対応致します。
2011/4/11
2011年
3月
29日
火